シニアアプリケーションスペシャリストによる「技術トレンド情報」(第20回)ハイパースペクトルイメージング その3コラム
公開日:2020年5月19日

前回では、ハイパースペクトルイメージング技術として、光の透過吸収性の違いを利用し、見えないものをみるソフトウェア技術をご紹介しました。今回は、ハイパースペクトルイメージングのもう一つの活用方法、光の波長ごとの干渉を利用し、厚みを測定する技術についてご紹介いたします。
ハイパースペクトルイメージング技術の波長干渉について
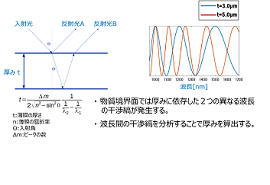
光の透過吸収性の違いにより、それがハイパースペクトルイメージング画像に反映される点は同じですが、その差異の各波長での干渉縞を利用することで、厚みを測定することができます。
物質の境界面で、厚みに依存した干渉縞が発生することを利用し、データキューブから干渉縞を検出・計算することで厚みを測定することができます。厚みといっても半導体の酸化膜や、FPD・フレキシブル基板などの用途で使われるフイルム素材などの、薄い膜厚測定に適しています。(図1)。
波長の干渉性を活用した処理事例
実際の膜厚測定の事例をご紹介します。「半導体ウエハの厚み測定」の例で、近赤外領域(500~900nm)のハイパースペクトル画像の干渉縞をもとに電極部と酸化膜の厚みを測定しています(図2)。
厚みを画像化することで、構造物、酸化膜、電極部上部、電極部下部についての厚みの状態が一目でわかります。ハイパースペクトルイメージングの測定分解能は、0.05%と非常に高分解能であるため、1点ごとの膜厚測定器と異なり、1面の膜厚を1度で測定でき、厚みごとの色分けやムラの検出などに活用できます(図3)
今回のまとめ
3回を通し、ハイパースペクトルイメージング技術、広域波長領域を高分解能で扱う技術をご紹介しました。マシンビジョンでは、こうした撮像技術と撮像後画像に対する画像処理技術(ソフトウェア技術)の両面で進化をし続けています。今後もマシンビジョンや画像処理に関する、基礎技術から最新技術、業界の動向などをお届けいたします。
筆者紹介

稲山 一幸(いねやま かずゆき)エンジニアリング事業 シニアアプリケーションスペシャリスト
1992年住金制御エンジニアリング入社、Matrox社製品の国内総代理店立ち上げに参画、以降25年マシンビジョン業界に携わる。
2013年~2016年、キヤノン株式会社にてマシンビジョン関連の新製品開発のソフトウェアリーダとして従事。現在は、エバンジェリストとして活躍中。
関連するソリューション・製品
- 画像処理ソリューション
- 製造業における外観検査や異常検知、食品・医薬品・化粧品などにおける異物検査や成分量の測定、物流業における資材配置の点検などの課題に対して、最先端のマシンビジョンシステムを中心にソリューションを提供しています。
- 画像処理システム構築に必要な産業用カメラ、産業用パソコン、画像入力・処理ボード、ハイパースペクトルデータ処理や画像処理ライブラリ、さらにカメラと処理エンジンが一体化したAIスマートカメラなど、各種素材を取り揃えています。
- また、高い精度・高速処理が必要とされる各種検査機器、医療機器・印刷機器などに採用されたこれまでの経験を生かして、お客さまの課題やご要望をもとに最適な画像処理ソリューションをご提供していきます。